
- 由于具备低温固化特性,所以可以应用在实装时避免接触高温的精密元器件上
- 同时提高了需要具备高粘合强度要求的车载零部件的实装可靠性
半导体封装材料
- 型 号

CV5350AS
- 运 用
- 详细运用


・车载设备
・半导体封装
・半导体封装
用于车载照相机模块、车载毫米波雷达模块、ECU等各种半导体封装模式和电子零部件
特长
仅需低温80℃即可固化
固化后,Tg不小于140℃
固化后,Tg不小于140℃
由于高Tg值,所以与其他部分的
热收缩差异较小
热收缩差异较小
通过40mm的喷口能实现
在间隙仅20μm内的填充
在间隙仅20μm内的填充
室温下的莫尔数据

实现狭缝间隙区域内的填充
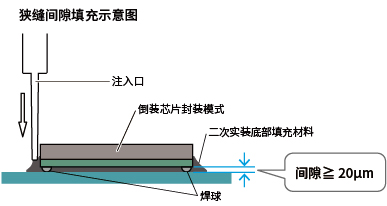
车载环境要求下的温度循环测试结果

常规参数
| 项目 | 単位 | CV5350AS |
| 最小填充间隙 | µm | 20 |
| 粘度 (25°C) | mPa·s | 4000 |
| 玻璃化转变温度 (Tg) | °C | 150 |
| C.T.E.1 | ppm/°C | 30 |
| 弹性率 (25°C) | GPa | 10 |
| 可否返工 | - | 不可 |
上述数据为本公司的实测值,并非保证值。